写在前面
原文链接
相关博文
博客首页
注:知识搬运,供学习交流使用,侵联删!
正文
场效应晶体管由Julius Lilienfeld在1926年和1933年(1,900,018)的美国专利中提出。 此外,肖克利(Shottleley),布拉顿(Brattain)和巴丁(Barden)在1947年正在研究场效应晶体管。尽管如此,极端的困难使他们转向发明双极晶体管。 肖克利的场效应晶体管理论于1952年发表。但是,直到1960年约翰·阿塔拉(John Atalla)生产了一种工作装置之后,材料处理技术才变得不够成熟。
场效应晶体管(FET)是一种单极器件,仅使用一种电荷载体传导电流。 如果基于N型半导体器件,则载流子为电子。 相反,基于P型的器件仅使用空穴。
场效应管操作
在电路一级,场效应晶体管的操作很简单。 施加到栅极输入元件的电压控制沟道的电阻,即栅极区域之间的单极区域。 (下图)在N沟道器件中,这是轻掺杂的N型硅平板,两端带有端子。 源极和漏极端子分别类似于BJT的发射极和集电极。 在N沟道器件中,平板中心两侧的较重的P型区域用作控制电极,即栅极。 该门类似于BJT的基极。
“洁净仅次于圣洁”适用于场效应晶体管的制造。 尽管可以将双极型晶体管制作在洁净室之外,但对于场效应晶体管而言却是必不可少的。 即使在这样的环境中,由于污染控制问题,制造还是棘手的。 单极场效应晶体管在概念上很简单,但是很难制造。 当今,大多数晶体管是集成电路中包含的场效应晶体管的金属氧化物半导体品种(后文)。 但是,可以使用分立的JFET器件。
注:field effect transistor (FET);场效应管
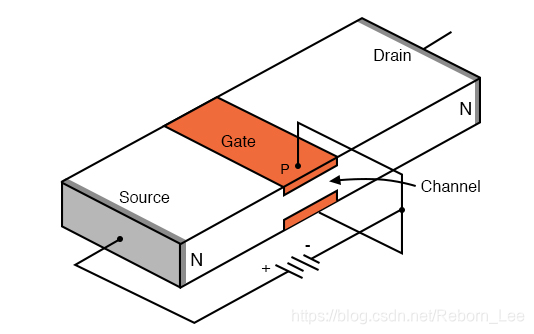
结场效应晶体管的横截面。
上图显示了正确偏置的N沟道结型场效应晶体管(JFET)。 栅极构成到源极的二极管结,以漏极排出半导体平板。 栅极反向偏置。 如果在源极和漏极之间施加电压(或欧姆表),则由于掺杂,N型条会在任一方向上导通。 导通既不需要栅极,也不需要栅极偏置。 如果如图所示形成栅极结,则可以通过反向偏置的程度来控制导电。
下图(a)显示了栅极结处的耗尽区。 这是由于空穴从P型栅极区域扩散到N型沟道,使结周围的电荷分离,在结处有非导电耗尽区。 由于重栅掺杂和轻沟道掺杂,耗尽区更深地延伸到沟道侧。
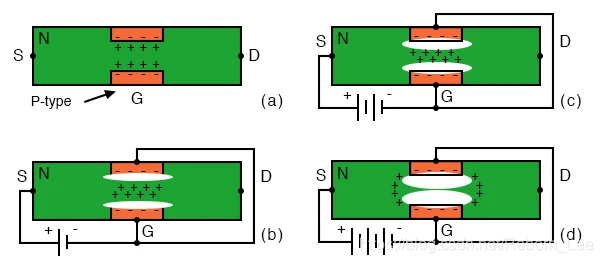
N沟道JFET:(a)栅极二极管耗尽。 (b)反向偏置的栅极二极管会增加耗尽区。 (c)增加反向偏压会扩大耗尽区。 (d)增加反向偏置会夹住S-D通道。
可以通过施加适度的反向偏压来增加耗尽区的厚度,如图b所示。 通过使沟道变窄,这增加了源极对漏极沟道的电阻。 在(c)处增加反向偏压会增加耗尽区,减小沟道宽度,并增加沟道电阻。 在(d)处增加反向偏置VGS将切断通道电流。 通道电阻将非常高。 发生夹断的VGS为VP,即夹断电压。 通常为几伏。 总之,可以通过栅极上的反向偏置程度来控制沟道电阻。
源极和漏极可互换,对于低电平漏极电池电压(<0.6 V),源极至漏极电流可沿任一方向流动。即,可以用低压交流电源代替漏电池。对于高漏极电源电压,对于小信号设备,其电压为10伏特,其极性必须如下图(a)所示。该漏极电源(以前的图中未显示)会使耗尽区失真,从而将其放大到栅极的漏极侧。对于从几伏到几十伏的常见DC漏极电源电压,这是更正确的表示。随着漏极电压VDS的增加,栅极耗尽区向漏极扩展。这增加了窄通道的长度,从而稍微增加了其阻力。我们之所以说“一点”,是因为较大的电阻变化是由于栅极偏置的变化引起的。下图(b)显示了与(a)处的硅横截面相比的N沟道场效应晶体管的示意图。栅极箭头指向与结型二极管相同的方向。
“指向”箭头和“非指向”条分别对应于P型和N型半导体。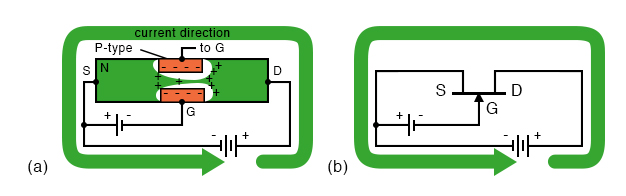
N沟道JFET电流从(a)横截面,(b)原理图中的漏极到源极流动。
上图显示了大电流从(+)电池端子流向FET漏极,再从源极流出,回到(-)电池端子。 该电流可以通过改变栅极电压来控制。 与电池串联的负载会看到不断变化的栅极电压的放大版本。
还提供P沟道场效应晶体管。 通道由P型材料制成。 栅极是重掺杂的N型区域。 与更流行的N通道设备相比,P通道电路中的所有电压源都反向(下图)。 还要注意,箭头指向P沟道场效应晶体管的示意图符号(b)的栅极之外。
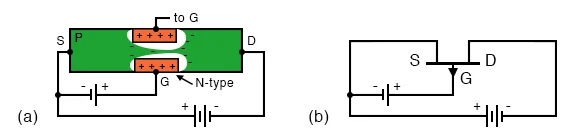
P沟道JFET:(a)与N沟道器件相比,N型栅极,P型沟道,反向电压源。 (b)注意原理图上反向的栅极箭头和电压源。
随着正栅极偏置电压的增加,P沟道的电阻增加,从而减少了漏极电路中的电流。
分立设备的制造横截面如下图所示。 定向为与示意图符号相对应的横截面相对于半导体晶片是上下颠倒的。 也就是说,栅极连接在晶圆的顶部。 栅极被重掺杂P +,以将空穴很好地扩散到沟道中,从而耗尽了较大的区域。 此N沟道器件中的源极和漏极连接被重掺杂N +,以降低连接电阻。 然而,围绕栅极的沟道是轻掺杂的,以允许来自栅极的空穴深深地扩散到沟道中。 那就是N区。
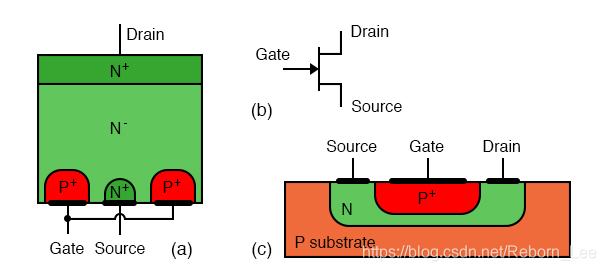
结型场效应晶体管:(a)分立器件截面,(b)原理图符号,(c)集成电路器件截面。
对于集成电路版本,所有三个FET端子都在管芯顶部可用,因此金属化层(未显示)可以互连多个组件。 (上图(c))在模拟电路中,集成电路FET用于高栅极输入电阻。 栅极下方的N沟道区域必须非常薄,以使栅极周围的本征区域可以控制和收缩沟道。 因此,沟道两侧的栅极区域不是必需的。
静电感应场效应晶体管(SIT)
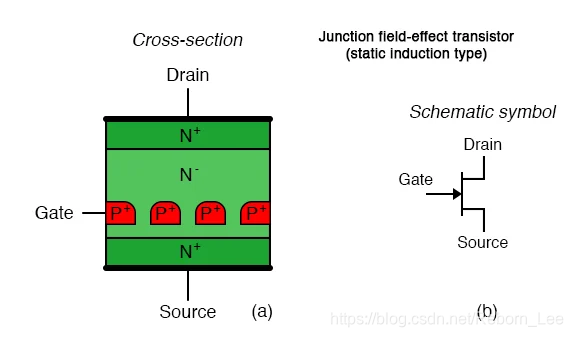
结型场效应晶体管(静电感应型):(a)横截面,(b)原理图符号。
静态感应场效应晶体管(SIT)是带有掩埋栅极的短沟道器件。 (上图)它是一种功率设备,而不是小信号设备。 低栅极电阻和低栅极至源极电容构成了一种快速开关器件。 SIT的能力为数百安培和数千伏。 并且据说具有10 gHz的惊人频率。
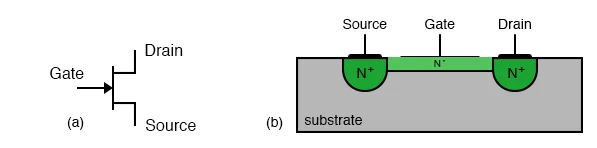
金属半导体场效应晶体管(MESFET):( a)示意图,(b)横截面。
金属半导体场效应晶体管(MESFET)
金属半导体场效应晶体管(MESFET)与JFET相似,除了栅极是肖特基二极管而不是结二极管。 与更常见的欧姆接触相比,肖特基二极管是半导体的金属整流接触。 在上图中,源极和漏极是重掺杂(N +)。 通道是轻度掺杂(N-)。 MESFET的速度高于JFET的速度。 MESFET是耗尽型器件,通常像JFET一样处于开启状态。 它们用作30 gHz的微波功率放大器。 MESFET可以由硅,砷化镓,磷化铟,碳化硅和碳的金刚石同素异形体制成。
回顾
之所以称为单极结型场效应晶体管(FET或JFET),是因为通道中的传导是由于一种载流子引起的。
JFET的源极,栅极和漏极分别对应于BJT的发射极,基极和集电极。
向栅极施加反向偏压会通过扩大栅极二极管的耗尽区来改变沟道电阻。