这篇文章探讨了质子辐照和正向栅极偏置应力对AlGaN/GaN异质结构界面陷阱的综合影响。研究发现,质子辐照和正向栅极偏置对平带电压(VFB)的偏移影响是独立的。通过使用频率依赖的电导技术,文章详细分析了金属/AlGaN界面和AlGaN/GaN界面陷阱密度(DT)和陷阱能级范围的变化。
主要发现包括:
- 质子辐照后,金属/AlGaN界面的陷阱密度降低,而AlGaN/GaN界面的陷阱密度略有增加。
- 在随后的正向栅极偏置应力下,金属/AlGaN界面的陷阱密度在最深能级处进一步降低,而AlGaN/GaN界面的陷阱密度显著降低。
- 质子辐照导致金属/AlGaN界面陷阱的能级范围变浅变宽,而正向栅极偏置应力使得能级范围变窄。
- 对于AlGaN/GaN界面陷阱,质子辐照后能级范围变深变宽,而正向栅极偏置应力后变化不大。
文章还讨论了质子辐照和电应力对AlGaN/GaN异质结构界面陷阱影响的机理,包括质子辐照引起的位移损伤、正向栅极偏置应力导致的漏电流路径的生成,以及这些因素如何影响界面陷阱的特性。
这项研究对于理解和改善GaN基高电子迁移率晶体管(HEMTs)在航天应用中的长期可靠性具有重要意义。研究结果表明,质子辐照和正向栅极偏置应力的综合效应对界面陷阱的影响比对AlGaN层中的体陷阱更为复杂。
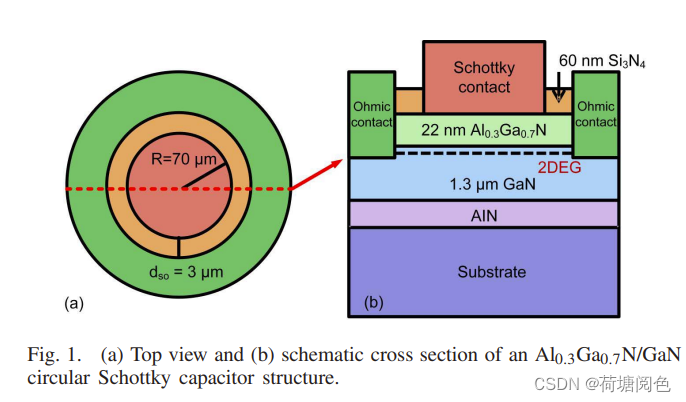
器件结构的细节如下:
-
器件顶视图:使用的是圆形肖特基电容器,用于测量。肖特基接触的半径为70微米,栅极和欧姆接触之间的距离为3微米。
-
器件横截面示意图:展示了器件的层次结构,包括以下部分:
- 180纳米厚的AlN成核层
- 1.3微米厚的未掺杂GaN缓冲层
- 22纳米厚的Al0.3Ga0.7N势垒层
-
欧姆接触:由Ti/Al/Ni/Au(22/140/55/45纳米)组成,在氮气氛围中850℃下退火30秒。
-
表面钝化:通过等离子体增强化学气相沉积(PECVD)沉积大约60纳米的Si3N4。
-
栅极电极:通过光刻、反应离子刻蚀(RIE)和电子束蒸发Ni/Au/Ni(45/200/20纳米)金属堆叠形成。
扫描二维码关注公众号,回复: 17381812 查看本文章
-
辐照实验:使用3 MeV质子对器件进行辐照,辐照剂量分别为5×10^13 H⁺/cm²、1×10^14 H⁺/cm²和5×10^14 H⁺/cm²,辐射剂量率约为6×10^9离子/(cm²·s),在室温下进行辐照实验。
-
电应力实验:辐照后的器件A、B和C施加了正向栅极偏置应力。恒定的正向栅极偏置应力条件为Vg = 3.5 V,Vd = Vs = 0 V。本研究中最大的电应力时间为10微秒。
-
测量:使用Agilent B1500A半导体分析仪在室温下进行C-V测量。使用频率相关的电导技术来表征金属/AlGaN界面和AlGaN/GaN界面的陷阱参数变化。测量频率范围为10 kHz至5 MHz。
实验方法细节包括以下几个关键步骤:
-
辐照实验:
- 使用3 MeV质子对器件进行辐照,辐照剂量分别为5×10^13 H⁺/cm²、1×10^14 H⁺/cm²和5×10^14 H⁺/cm²。
- 辐射剂量率约为6×10^9离子/(cm²·s),辐照在室温下进行。
-
电应力实验:
- 辐照后的器件施加了正向栅极偏置应力,条件为Vg = 3.5 V,Vd = Vs = 0 V。
- 最大电应力时间为10微秒。
-
C-V测量:
- 使用Agilent B1500A半导体分析仪在室温下进行C-V(电容-电压)测量。
- 测量频率依赖性导电技术用于表征金属/AlGaN界面和AlGaN/GaN界面的陷阱参数变化。

-
频率依赖性导电技术:
- 测量频率范围为10 kHz至5 MHz,以确保只检测界面陷阱。
- 使用以下公式计算等效并联电导GP/ω=Gm/(Cm−Cb+jωCmGm) 其中Gm和Cm分别是测量的电导和电容,Cb是总电容,由C-V曲线中的二维电子气通道中的电子积累平台确定。
-
数据分析:
- 通过拟合GP/ω与频率ω的关系来定量表征界面陷阱参数的变化。
- 使用特定的公式来提取界面陷阱的能级(ET)和陷阱密度(DT)。