1.3晶体三极管
1.3.1晶体管的结构及类型
根据不同的掺杂方式在同一个硅片上制造出三个掺杂区域,并形成两个PN结,就构成晶体管。采用平面工艺制成的NPN型硅材料晶体管的结构如图 (a)所示,位于中间的P区称为基区,它很薄且杂质浓度很低;位于上层的N区是发射区,掺杂浓度很高;位于下层的N区是集电区,面积很大;晶体管的外特性与三个区域的上述特点紧密相关。它们所引出的三个电极分别为基极b、发射极e和集电极c。图(b)所示为NPN型管的结构示意图,发射区与基区间的PN结称为发射结,基区与集电区间的PN结称为集电结。图©所示为NPN型管和PNP型管的符号。【箭头方向从P级指向N级,是二极管正向电压的方向】
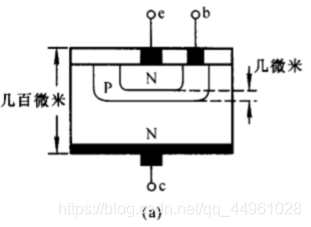
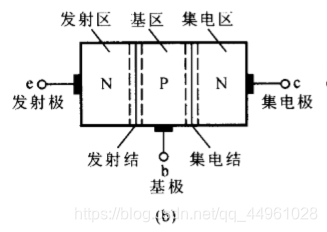
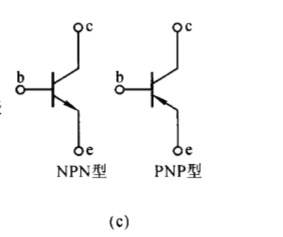
1.3.2 晶体管的电流放大作用
【注:】这部分在后面章节会详细说,这里也很重要,记得打牢基础哦~
**放大是对模拟信号最基本的处理。**在生产实际和科学实验中,从传感器获得的电信号都很微弱,只有经过放大后才能作进一步的处理,或使之具有足够的能量来推动执行机构。晶体管是放大电早路的核心元件,它能够控制能量的转换,将输入的任何微小变化不失真地放大输出。
**共射放大电路:**共射放大电路顾名思义,就是将他的发射极作为公共端。在书上是这样的:
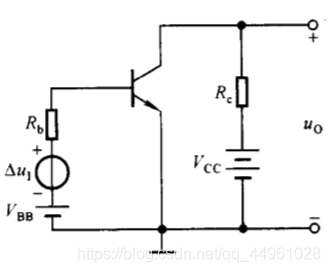
具体原理构成我们在后面说,从图中我们可以看出这是一个NPN型管,下面使它的发射极。而他的发射极将其他电路连接起来了,所以被称为了共射放大电路。二晶体管的工作状态和之前的二极管是相关的,首先我们看的出来,基极和集电极都是电流输入的方向,而发射极肯定就是电流流出的方向了。接下来我们剖析一下下面这张图:
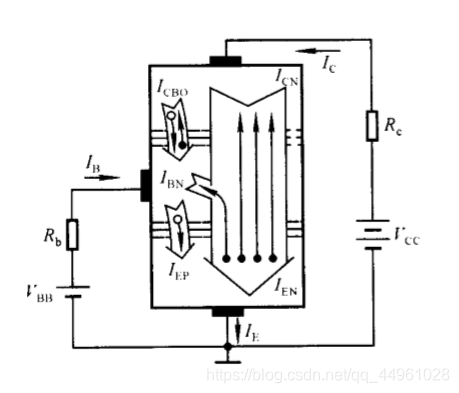
自我总结
首先我们分析一下:
在发射结中,我们加入正向电压,由于P中的空穴是多子,所以因为发射结的正偏,所以空穴向发射极扩散形成了电流IEP。由于发射极的掺杂浓度高,所以P区的多子【电子】向基极扩散开,形成途中的大电流【大箭头表示正电荷方向,其中的黑色是电子流动方向】。
由于基区很薄,并且掺杂浓度很低,而集电结又加入了反向电压【为了吸收基区的电子】,所以仅有少数电流IBN于基区复合,大多数的电子都冲到了集电极形成了ICN。需要注意的是集电结还有少量的漂移运动形成了IBO。
那么我们来总结一下电流的等式:
IE = IEN +IEP = ICN + IBN + IEP
**IC = ICN + ICBO **
IB = IBN + IEP - ICBO = I’B + ICBO
而我们知道,无论内部如何变化,他对外都会体现出一个等式,我们进行总结得到:
IE = IC + IB
这部分如果不清楚可以多看看,对后面学习比较重要,书上的总结比我写的要复杂很多,我放到下面:
课本详解
1.发射结加正向电压,扩散运动形成发射极电流IE
因为发射结加正向电压,又因为发射区杂质浓度高,所以大量自由电子因扩散运动越过发射结到达基区。与此同时,空穴也从基区向发射区扩散,但由于基区杂质浓度低,所以空穴形成的电流非常小,近似分析时可忽略不计。可见,扩散运动形成了发射极电流IE。
2.扩散到基区的自由电子与空穴的复合运动形成基极电流IB
由于基区很薄,杂质浓度很低,集电结又加了反向电压,所以扩散到基区的电子中只有极少部分与空穴复合,其余部分均作为基区的非平衡少子达到集电结。又由于电源VBB的作用,电子与空穴的复合运动将源源不断地进行,形成基极电流IB。
3.集电结加反向电压,漂移运动形成集电极电流Ic
由于集电结加反向电压且其结面积较大,基区的非平衡少子在外电场作用下越过集电结到达集电区,形成漂移电流。与此同时,集电区与基区的平衡少子也参与漂移运动,但它的数量很小,近似分析中可忽略不计。可见,在集电极电源Vcc的作用下,漂移运动形成集电极电流Ic。
设由发射区向基区扩散所形成的电子电流为lEN,基区向发射区扩散所形成的空穴电流为lEP, 基区内复合运动所形成的电流为IBN,基区内非平衡少子(即发射区扩散到基区但未被复合的自由电子)漂移至集电区所形成的电流为ICN,平衡少子在集电区与基区之间的漂移运动所形成的电流为ICBO
相信经过对于这部分知识的二刷,大家肯定已经掌握了这部分的知识了,那么我们就开始下一部分的知识:
晶体管的公设电流放大系数
因为在书中的范围,对于直流和交流在放大系数没有太大差别,为了方便我的输入,我们就统一用β和α了,如果需要区分的话我们通常会在直流分析中,在两个希腊字母上加上一个横杠~
首先来说一下放大系数β:

我们这里再简单分析一下:放大系数其实就是基区和集电区对于发射区所谓贡献的比例【个人理解】回到之前的箭头那张图,我们发现,IC实际上对于IN所做的贡献不过就是ICN,而ICBO则是基区和集电区的漂移电流。
而基区实际有的空穴数量是电流IB和ICBO的总和。
所以等式成立。

式中ICEO称为穿透电流,其物理意义是,当基极开路(I`B=0)时,在集电极电源Vcc作用下的集电极与发射极之间形成的电流,而lCBO是发射极开路时,集电结的反和饱和电流。一般情况下,IB >> ICBO, β >> 1,所以

而在交流中,放大系数我们通常用这样的公式计算:

因为穿透电流非常小,所以,我们在|△iB|不大的情况下,可以认为
当以发射极电流作为输人电流,以集电极电流作为输出电流时,ICN与 IE之比称为共基直流电流放大系数
 关于α目前我也不是很会用,如果后面会了回来补充的。
关于α目前我也不是很会用,如果后面会了回来补充的。

1.3.3 晶体管的共射特性曲线
输入特性曲线
昨天复习到了放大电路的性能指标,发现特性曲线的重要性,正好今天还能复习一遍:
输人特性曲线描述管压降UCE一定的情况下,基极电流iB 与发射结压降uBE之间的函数关系,即

当UCE=0 V时,相当于集电极与发射极短路,即发射结与集电结并联。因此,输入特性曲线与PN结的伏安特性相类似,呈指数关系。
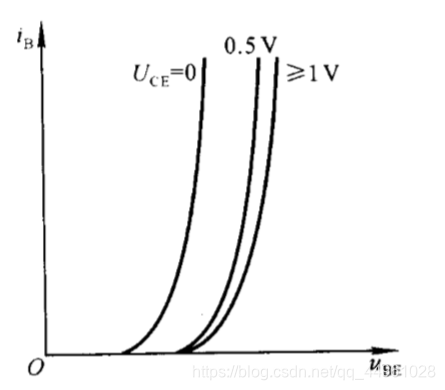
书中的详细解释
当UCE增大时,曲线将右移。这是因为,由发射区注人基区的非平衡少子有一部分越过基区和集电结形成集电极电流iC,使得在基区参复合运动的非平衡少子随UCE的增大(即集电结反向电压的增大)而减小;因此,要获得同样的iB,就必须加大uBE,使发射区向基区注入更多的电子。
实际上,对于确定的UBE,当UCE增大到一定值以后,集电结的电场已足够强,可以将发射区注人基区的绝大部分非平衡少子都收集到集电区,因而再增大UCE, iC也不可能明显增大了,也就是说,iB 已基本不变。因此,UCE超过一定数值后,曲线不再明显右移而基本重合。对于小功率管,可以用UCE大于1 V的任何一条曲线来近似UCE大于1 V的所有曲线。
本人理解
首先看单条曲线我们可以知道,uBE作为发射结压降,处于正偏,所以它的曲线和二极管的正偏曲线极为相似。
那么当我们增大集电极的电压的时候,发射区的非平衡少子来到基区,而由于集电极电压加大,又被集电区吸收了【扩散运动】,所以留下来于基区的非平衡少子符合的就少了,所以基区的非平衡少子数目先对而言就多了起来,也就是削弱了iB。
当UCE足够大的时候,几乎所有发射区到基区的非平衡少子都被集电区吸收了,所以即使在增大UCE也很难在吸收更多发射区到基区的非平衡少子,所以,iB就基本不变了。
自己梳理了一遍感觉好多了。
输出特性曲线
输出特性曲线描述基极电流IB为一常量时,集电极电流iC与管压降UCE之间的函数关系,即

对于每一个确定的IB,都有一条曲线,所以输出特性是一族曲线,如图:
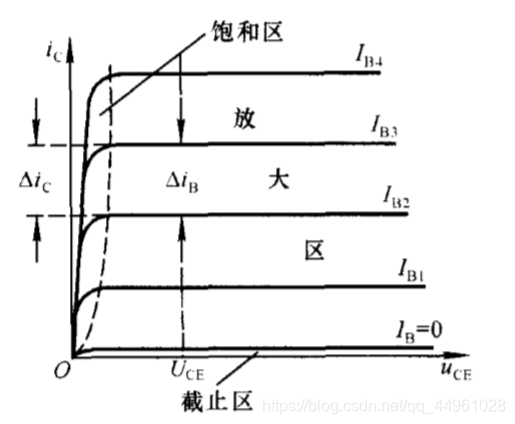
书上定义
对于某一条曲线,当uCE从零逐渐增大时,集电结电场随之增强,收集基区非平衡少子的能力逐渐增强,因而iC 也就逐渐增大。而当uCE增大到一定数值时,集电结电场足以将基区非平衡少子的绝大部分收集到集电区来,uCE再增大,收集能力已不能明显提高,表现为曲线几乎平行于横轴,即iC几乎仅仅决定于lB。
从输出特性曲线可以看出,晶体管有三个工作区域:
- 截止区:其特征是发射结电压小于开启电压且集电结反向偏置。对于共射电路,uBE≤Uon且 uCE> uBE。此时IB=0,而iC≤ICEO。 小功率硅管的ICEO在1μA以下,锗管的ICEO小于几十微安。因此在近似分析中可以认为晶体管截止时的iC≈0。
- 放大区:其特征是****。对于共射电路,uBE> Uon且uCE≥uBE。此时,iC 几乎仅仅决定于iB, 而与uCE无关,表现出iB对iC 的控制作用,IC= βIB,△iC =β△iB。在理想情况下,当IB按等差变化时,输出特性是一族横轴的等距离平行线。
- 饱和区:其特征是发射结与集电结均处于正向偏量。对于共射电路,BE> Uon且uCE< UBE。此时iC不仅与iB有关,而且明显随uCE增大而增大,iC小于βlB。在实际电路中,若晶体管的uBE增大时,iB 随之增大,但iC增大不多或基本不变,则说明晶体管进入饱和区。对于小功率管,可以认为当uCE= uBE,即UCE=0V时,晶体管处于临界状态,即临界饱和或临界放大状态。
在模拟电路中,绝大多数情况下应保证晶体管工作在放大状态。
本人理解
说实话,在不懂原理的时候看这张图,总觉得放大区和饱和区是不是写反了,但是当了解到远离以后,就开始清除了,那么接下来我们继续以单一曲线为例先分析单条曲线:
这里先用IB2举例吧:
最初的时候集电极从头开始增加的时候,基极的电压高于集电极和发射极,所以两个PN结均处于正向偏置,我们根据以前所学的知识推断一下,继续从iB开始,由于两个PN结均处于正偏,所以iB对两边都会输入多子【空穴】,那么由于发射结的掺杂浓度高,就会发射出大量电子,而此刻的集电区因为电压低,所以并没有收集电子的能力,相反,由于PN结的存在,然而会排斥,这个时候,大量的电子就在基极复合。而随着集电极电压的升高,集电区逐步恢复收集能力。所以产生了饱和区的现象。那么饱和区为什么叫饱和区呢?重点在这:因为当我们在饱和区的时候,增加基极电压的时候,iB虽然增加了,但是这并不能影响发射区来到基区的电子和基区的空穴符合的事实,于是乎,这和ic似乎就没有什么事儿了,所以iC在此刻就很尴尬,只能继续随着uCE的增长而增长。那么在这里对于IB的无动于衷,我们将之称为饱和。
那么度过了这么尴尬的时期我们继续往后看,这个时候当集电极的电压终于高过了基极电压的时候,翻身农奴把歌唱了。这个时候的集电区终于拥有了吸收电子的能力,这个时候多数的电子就投入到了集电区的怀抱中,而基极,只能收集少数的电子和空穴符合。而随着集电区的手机能力越来越强,到最后几乎把所有的电子都吸收过来了的时候【注意,还有极少数的在和B复合】。那么这个时候,集电区坐拥亿万家产,即使再有钱【吸收能力再强】,也很难在吸收更多的电子了,所以趋近于平衡了。那它被称为放大区又是为什么呢?因为在这个时候,只有基区电流增大,让发射区受到更多的空穴,发射区才会被刺激,发射更多的电子,这个时候,iC就增大了。
所以无论是饱和区还是放大区,所关系的其实只是 iC和IB的电流大小。
嗯,不管你们理解没,反正我终于算是明白了【原本自己糊里糊涂,总结一边清楚多了】
那么最后来看一下截止区:也就是当我们基极电压小,达不到Uon,那么这个时候就很难引起发射区的电子产生大电流,但是在这个时候,总有那么一点有想法的。就比如,发射区总有那么一点电子会击穿PN,形成微小电流ICEO,由于真的太小了,所以在近似分析中,我们忽略不计。
1.3.2 晶体管的主要参数



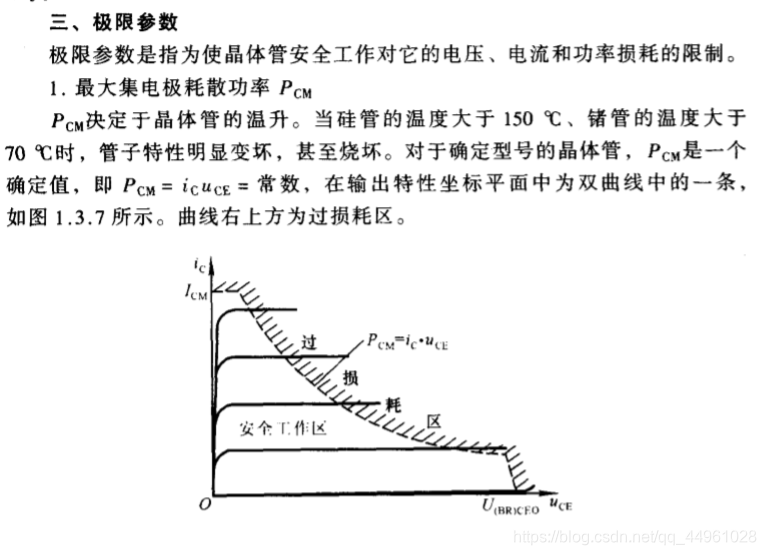


在这里我们需要注意的是极限放大参数,他是限制管子的一个重要指标,我们在分析的时候一定要注意关于功率的数据考虑。
1.3.5温度对晶体管特性的影响
这部分的知识参考之前二极管和PN结的内容,其实大多数可以自己推导出来,大部分数据也和二极管相同,也不做赘述了。
不得不说这一片我写了很久了,从前天写到今天,画了接近三天,六七个小时,在写的同时也在自己整理,收获颇多,也希望对大家有帮助。后面的更新速度也会慢一些,因为还有继续复习上课啥的,每天抽出来的时间确实有限,希望大家可以一同进步。
