Huawei Technologies Co., Ltd.は最近、出願公開番号 CN116601748A で「熱性能が向上したフリップチップ パッケージ」というタイトルの特許を公開しました。
この特許の実施形態は、フリップチップパッケージ、パッケージ構造を適用する回路を備えたデバイス、およびパッケージを組み立てる方法を提供する。
より直観的には、これはチップとヒートシンクの間に接触を提供する方法であり、放熱性能の向上に役立ちます。CPU、GPU、FPGA (フィールド プログラマブル ゲート アレイ)、ASIC (特定用途向け集積回路) などのチップ タイプに適用できます。デバイスには、スマートフォン、タブレット、ウェアラブル モバイル デバイス、PC、ワークステーション、サーバーなどが含まれます。
この特許では、最近の半導体パッケージングの取り扱い性能の進歩により、安定した動作を確保するために熱性能に対する要求が高まっていると述べています。この点において、フリップチップパッケージングは、チップがその下のバンプを介して基板に接続され、チップの上面にヒートシンクを配置できるという構造的特徴により、熱性能の点で利点をもたらします。
通常、冷却性能を向上させるために、サーマル グリースのようなサーマル インターフェイス マテリアル (TIM) がチップの上面に塗布され、チップとヒート シンクの少なくとも一部の間に挟まれます。TIMの熱抵抗を低減してパッケージの熱性能を向上させる観点から、TIMの厚さは薄くされています。

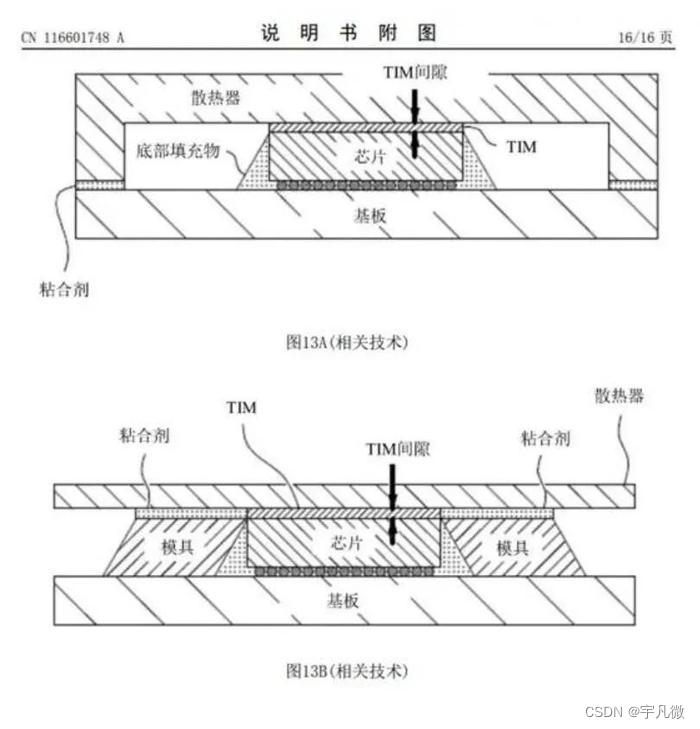
TIMの厚さを微調整することが困難だった以前の熱放散方式と比較して、ファーウェイの特許におけるサーマルインターフェースマテリアルの厚さは、成形コンポーネントの壁状構造の高さによって制限されます。モールドコンパウンドで構成される壁状構造の高さは成形プロセス中に簡単に制御できるため、サーマルインターフェイスマテリアルの厚さを必要な最小厚さに調整でき、結果として熱性能が向上します。
フリップチップ実装技術は、電子機器の設計をより柔軟かつ多様にすることが期待されています。フリップチップ実装により、回路基板上にチップをよりコンパクトに配置できるため、製品のサイズをさらに縮小することができ、携帯電話、タブレットコンピュータ、スマートウェアラブルデバイスなどの薄型軽量化が実現します。同時に、携帯電話機器の放熱問題も大幅に改善されます。
ただし、このパッケージング技術には多くの技術的な制限もあり、たとえば、フリップチップパッケージングではチップ裏面に複雑な配線と接続が必要となるため、製造プロセスに高い要件が課せられ、製造コストが増加する可能性があります。次に、信頼性の問題があります。フリップチップ実装ではチップが直接外部に露出するため外部環境の影響を受けやすく、チップの安定動作を確保するためにはより強固な保護対策が必要となります。
まだ特許段階の技術のため、実際にいつ実用化されるかは不明だ。一般に、特許技術は技術検証の段階から最終的な実用化までに一定の期間を要しますが、中には技術留保として使用され、二度と適用されない技術もあります。
ファーウェイの現状によれば、チップパッケージングなどの技術は商業的な大量生産がより困難になる可能性が高い。
消費者市場では、Yufan Micro も最新の高周波チップ封止技術、特許番号 CN 218677151 U を発表しました。この実用新案は半導体パッケージング技術の分野に属し、MCU と高周波チップを統合したパッケージを提供し、マイクロコントロールチップ(MCU)と無線周波数チップの機能。
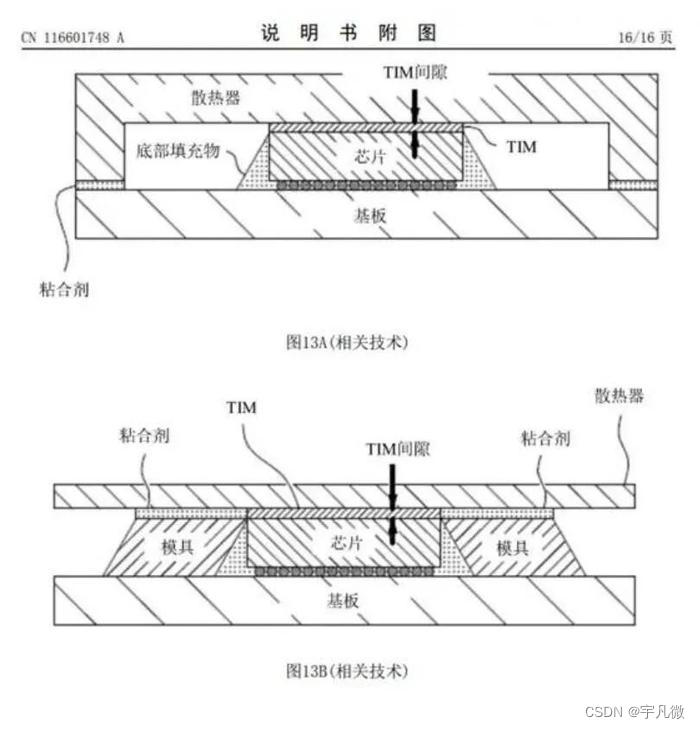
主に2.4gチップまたは433mチップとMCUパッケージで構成されており、RFパッケージチップは発売後、リモコン市場で広く受け入れられており、超高コストパフォーマンスはリモコン市場で勝つための魔法の武器です消費者市場は、小売業者があらゆる面でコストを削減するのに役立ちます。詳細はYufanwei公式サイト(www.yufanwei.com)をご覧ください。